Da Intel e Berkeley Lab nuovo photoresist per la litografia EUV
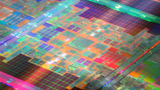
Un resist che unisca alta sensibilitŕ ed elevata risoluzione ed accuratezza č allo studio per applicazioni con la litografia Extreme Ultraviolet
di Andrea Bai pubblicata il 22 Luglio 2014, alle 14:29 nel canale Scienza e tecnologiaIntel
Intel Corporation e i Berkeley National Laboratories hanno collaborato allo sviluppo di un nuovo speciale photoresist che potrebbe risultare particolarmente adatto alle esigenze produttive per i nodi avaznati a 10 nanometri e oltre, impiegando la litografia Extreme Ultraviolet.
Con il termine photoresist si indica una particolare sostanza che viene applicata, nel processo di produzione dei semiconduttori, al wafer di silicio cosě da poter impressionare su di esso il pattern del chip tramite un processo di esposizione ad una fonte di energia e con l'uso di un'opportuna maschera sulla quale č riportato il pattern.
Le fonti di luce Extreme Ultraviolet sono progettate per una pulsazione nell'ordine dei femtosecondi, per evitare di danneggiare il chip. Solamente i photoresist ad alta sensibilitŕ sono in grado di operare con questi tempi di esposizione cosě rapidi. Il tipo di photoresist necessari - quelli di tipo corss-link per via della loro elevata risoluzione e per la migliore stabilitŕ meccanica - richiedono perň tempi di esposizione piů lunghi. La missione di Intel e dei Berkely Lab č quindi stata quella di creare un "super-resist" che possa consentire la realizzazione di linee nette e precise, ma con la sensibilitŕ necessaria per la luce EUV.
Paul Ashby, scienziato dei Berkeley Labs che ha lavorato alla ricerca, ha osservato: "I resist oggi usano una formulazione cross-link -ovvero con alcune molecole che si legano tra loro una volta esposti alla radiazione elettromagnetica - per la stabilitŕ meccanica, ma hanno una bassa sensibilitŕ e possono quindi essere utilizzati solamente con al litografia di tipo e-beam. La fotolitografia fa invece uso di resist amplificati che hanno una maggior sensibilitŕ alla luce. La nostra idea č stata quindi quella di diluire il cross-lining e aggiungere un resist amplificato in maniera tale da avere insieme i vantaggi dell'alta sensibilitŕ e della stabilitŕ meccanica".
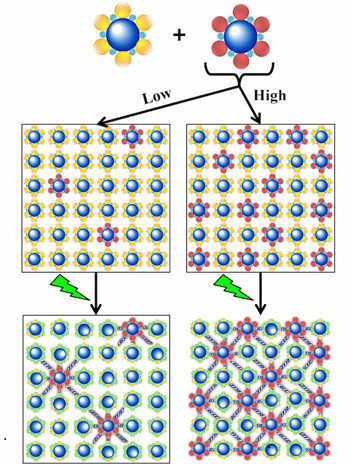
Una bassa concentrazione di crosslinker (a sinistra) permette al resist di tracciare linee accurate e non richiede lunghe esposizioni, al contrario di quanto accade con un'elevata concentrazione di crosslinker.
Il nuovo tipo di photoresist č indirizzato in maniera specifica alla litografia EUV, dove sono necessarie sensibilitŕ e stabilitŕ meccanica, anche se i ricercatori sperano che esso potrŕ migliorare la precisione e l'accuratezza del profilo delle linee del pattern, aspetto sempre piů importante avvicinandosi ai 10 nanometri.
"Alta risoluzione, profilo dei bordi e sensibilitŕ sono le tre proprietŕ piů importanti nel campo della litografia, motivo per cui le vogliamo migliorare tutte e tre allo stesso modo. Di norma c'č un compromesso tra sensibilitŕ e risoluzione o asperitŕ dei bordi. Ma qui cerchiamo di mantenere un'elevata sensibilitŕ del resist e di spingere anche sulla risoluzione" ha spiegato Ashby.
I photoresist, ora fermi a prove sperimentali di laboratorio, potranno essere commercializzati solamente dopo che i produttori saranno riusciti a rendere questa formulazione commercialmente sostenibile. Vi sono ancora alcuni anni di "cuscinetto" per sviluppare ulteriormente questi nuovi resist dato che la produzione Extreme Ultraviolet sarŕ pronta per i volumi commerciali non prima del 2017.
I Berkeley Labs pianificano ora di estendere lo studio su questi nuovi materiali per comprendere le proprietŕ dei sottoprodotti del processo. I ricercatori hanno inoltre giŕ affinato la formulazione in maniera tale che sia possibile realizzare pattern dai bordi ancor piů precisi anche una volta superato il nodo dei 10 nanometri.
"Ciň che vogliamo č comprendere i meccanismi che portano ad elevate risoluzioni con bassa asperitŕ dei bordi, per progettare resist ancor migliori attorno alle nostre scoperte" ha concluso Ashby. Il progetto č finanziato da Intel, JSR Micro, e l'Office of Science del Dipartimento dell'Energia USA.







 La Formula E può correre su un tracciato vero? Reportage da Misano con Jaguar TCS Racing
La Formula E può correre su un tracciato vero? Reportage da Misano con Jaguar TCS Racing Lenovo LEGION e LOQ: due notebook diversi, stessa anima gaming
Lenovo LEGION e LOQ: due notebook diversi, stessa anima gaming_L.jpg) Nothing Ear e Ear (a): gli auricolari per tutti i gusti! La ''doppia'' recensione
Nothing Ear e Ear (a): gli auricolari per tutti i gusti! La ''doppia'' recensione HiSolution amplia i propri servizi e punta sempre più sulla cybersicurezza
HiSolution amplia i propri servizi e punta sempre più sulla cybersicurezza F1 24 introdurrà migliorie al modello di guida, una carriera rinnovata e molto altro ancora
F1 24 introdurrà migliorie al modello di guida, una carriera rinnovata e molto altro ancora Arriva Omnissa, che prenderà in carico i prodotti per "utenti finali" di VMware
Arriva Omnissa, che prenderà in carico i prodotti per "utenti finali" di VMware Turista americano torna dall'Europa e si trova una bolletta telefonica da 135 mila euro per il roaming
Turista americano torna dall'Europa e si trova una bolletta telefonica da 135 mila euro per il roaming Larian al lavoro su due nuovi giochi, creati con la stessa 'passione' di Baldur's Gate 3
Larian al lavoro su due nuovi giochi, creati con la stessa 'passione' di Baldur's Gate 3 Microsoft Office LTSC 2024 disponibile in anteprima pubblica su Windows e Mac
Microsoft Office LTSC 2024 disponibile in anteprima pubblica su Windows e Mac Fallout 4 è il gioco più venduto in Europa! Le vendite schizzano del 7500% grazie alla serie TV
Fallout 4 è il gioco più venduto in Europa! Le vendite schizzano del 7500% grazie alla serie TV Razer Kishi Ultra: ecco il controller per ogni tipo di smartphone (o iPad mini)
Razer Kishi Ultra: ecco il controller per ogni tipo di smartphone (o iPad mini) Il Dimensity 6300 di MediaTek porta il 5G mainstream e tanto altro nella fascia media
Il Dimensity 6300 di MediaTek porta il 5G mainstream e tanto altro nella fascia media Google combina i team Android, Chrome e hardware: focus sull'IA
Google combina i team Android, Chrome e hardware: focus sull'IA Axiante vuole indagare come le imprese italiane affrontano la pianificazione aziendale
Axiante vuole indagare come le imprese italiane affrontano la pianificazione aziendale Italia quinto mercato europeo per i videogiochi: aumenta la spesa, ma diminuisce il tempo di gioco
Italia quinto mercato europeo per i videogiochi: aumenta la spesa, ma diminuisce il tempo di gioco Apple celebra la Giornata della Terra con sfide, innovazioni e impegno per l'ambiente
Apple celebra la Giornata della Terra con sfide, innovazioni e impegno per l'ambiente 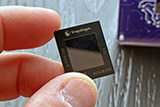 La funzionalità 'AI Explorer' di Windows 11 sarà inizialmente esclusiva dei PC con CPU ARM?
La funzionalità 'AI Explorer' di Windows 11 sarà inizialmente esclusiva dei PC con CPU ARM?












_XXL.jpg)






2 Commenti
Gli autori dei commenti, e non la redazione, sono responsabili dei contenuti da loro inseriti - infoSe non fosse stato per tutti gli accrocchi che si sono inventati per spingere ulteriormente i processi produttivi gia in uso, mi sa che ci saremmo già fermati con la riduzione della feature size già nel 2005 ... 2008.
Devi effettuare il login per poter commentare
Se non sei ancora registrato, puoi farlo attraverso questo form.
Se sei già registrato e loggato nel sito, puoi inserire il tuo commento.
Si tenga presente quanto letto nel regolamento, nel rispetto del "quieto vivere".